
研发能力
聚焦纳米科技,推动产业创新发展
设备介绍
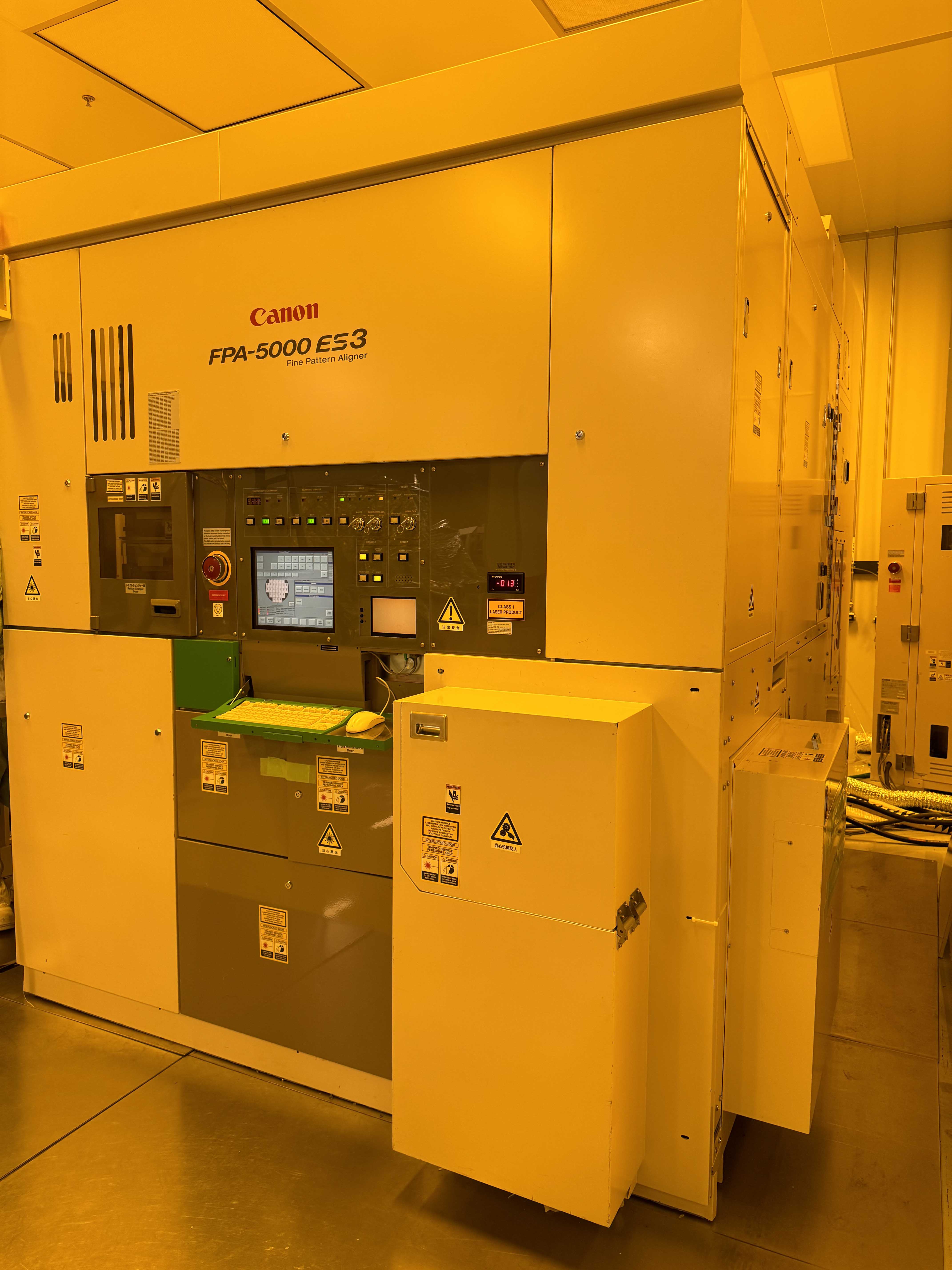
CanonFPA-5000ES3
全自动扫描投影光刻机
对晶圆表面的光刻胶进行曝光,实现掩膜图形转移功能。
6/8英寸兼容,分辨率300 nm,自动投影式曝光,均匀性±5%,自动传片

Nikon NSR-2005I9C
全自动步进投影光刻机
对晶圆表面的光刻胶进行曝光,实现掩膜图形转移功能。
6/8英寸兼容,分辨率500 nm,自动投影式曝光,均匀性±5%,自动传片

合肥真萍 MD-40
HMDS涂覆机
光刻胶黏附剂气相涂覆。支持氮气氛围,控温范围: 室温+30℃~200℃,温度均匀性: ±5%,温度波动度: ±0.5℃,腔体尺寸: 450mm*450mm*450mm。

SUSS MA200Gen3
全自动接触式光刻机
全自动接触式曝光,可进行全自动化批量生产。
6/8英寸兼容,紫外曝光,分辨率1μm,均匀性±2.5%,支持接近式曝光。

SUSS ACS200GEN3
自动涂胶显影机
对晶圆自动涂胶、显影与烘烤,进行全自动化批量生产。6/8英寸兼容,支持3种以上光刻胶,支持前后烘功能,均匀性±5%,自动传片。

SUSS MA8Gen4
接触式光刻机#1
半自动接触式曝光。6/8英寸兼容,紫外曝光,分辨率1μm,均匀性±5%,支持接近式曝光。

SUSS MA6Gen4
接触式光刻机#2
半自动接触式曝光。4/6英寸兼容,紫外曝光,分辨率1μm,均匀性±5%,支持接近式曝光。

EVG-6200NT
接触式光刻和键合对准一体机
对晶圆进行正面、背面套准光刻,键合前对位夹持,实现光刻胶的曝光和键合前对位功能。
6/8英寸兼容,紫外曝光与键合对准,分辨率1μm,均匀性±5%,支持背面套刻。
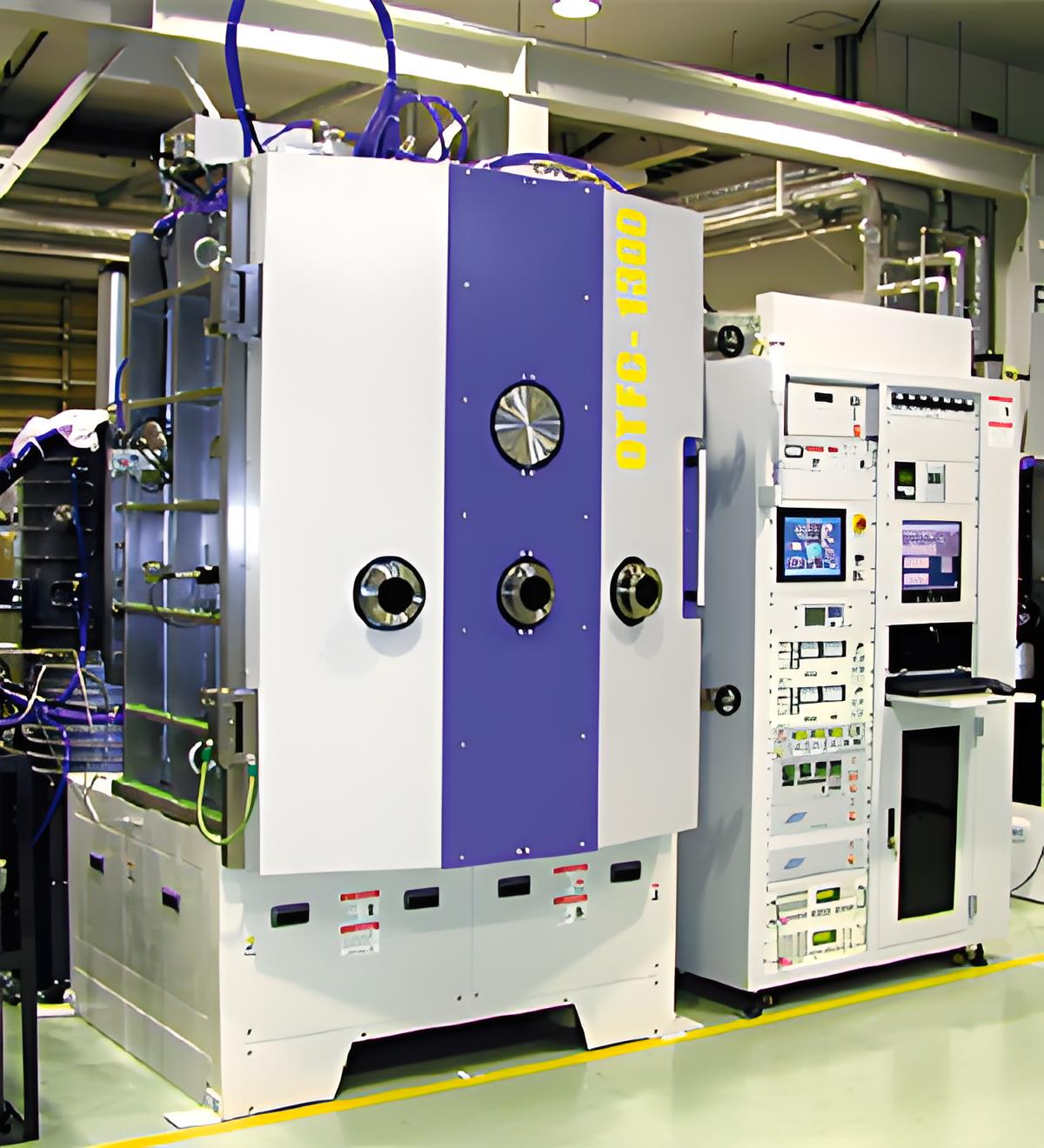
OPTORUN OTFC-1300CBI
光学镀膜仪
光学类(减反射膜、高反射膜、分光膜和滤光膜等)薄膜蒸镀。4/6/8英寸兼容,支持3个以上坩埚,介质膜沉积,均匀性±5%,片间均匀性±5%;光学玻璃、石英等衬底上镀减反射膜、高反射膜、分光膜和滤光膜,以及其他功能性薄膜材料。

ULVAC SOPHI-260
离子注入机
适用于6/8英寸,支持3种以上掺杂源,注入能量可达200keV,注入角度可调整,具备自动传片功能,注入工艺常见元素B、P;均匀性≦1.5%;注入剂量、注入角度、注入深度、横向扩散等方面进行精确的控制。
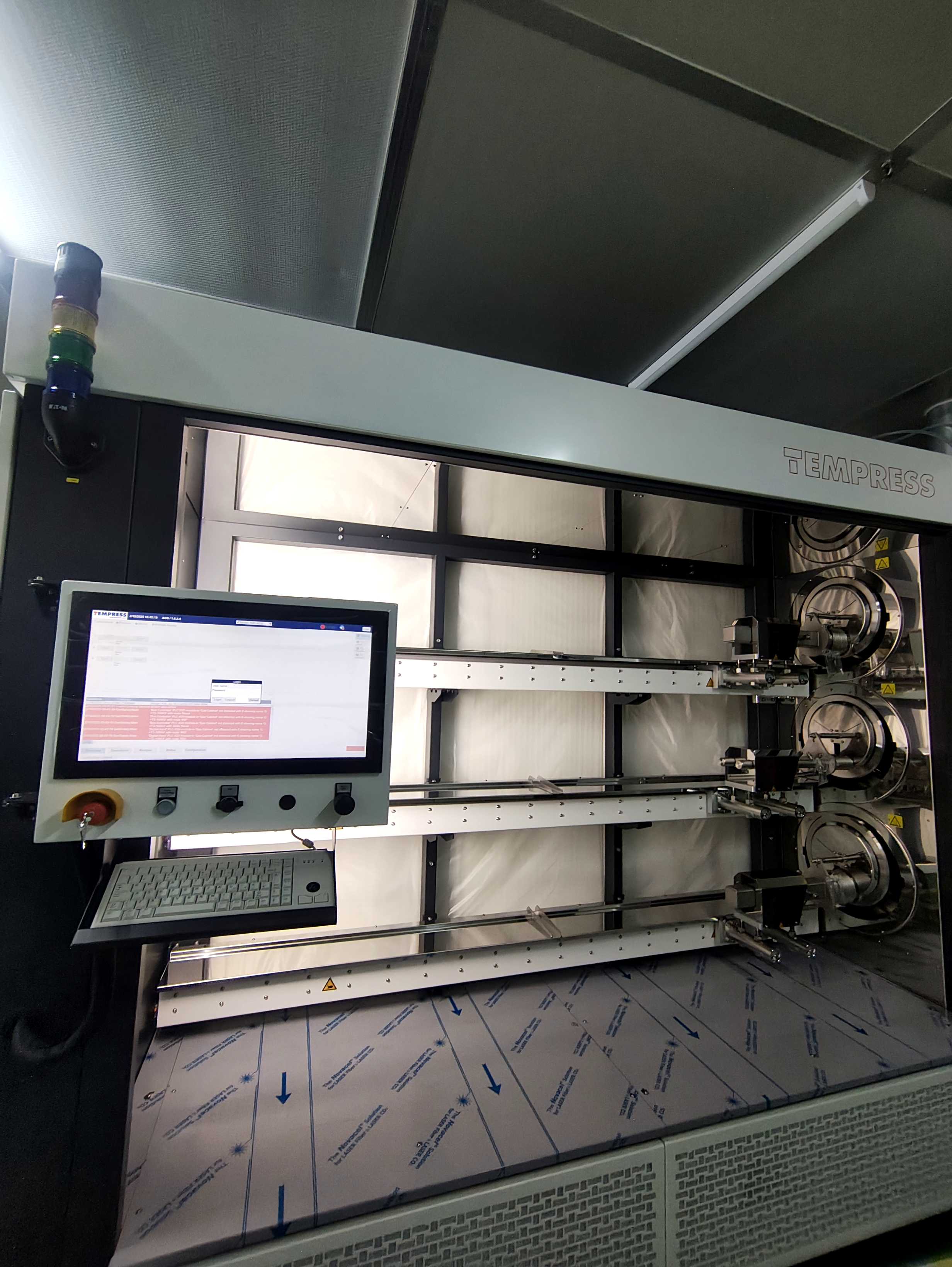
荷兰 Tempress Systems TS8603BM
氧化炉
6/8英寸兼容,最高温度1100℃,膜厚均匀性±3%,折射率+-0.01,支持50片以上晶圆,炉管内控温精度±0.5℃,片内均匀性≤5%,片间均匀性≤5%,晶圆样本的干氧氧化,氢氧合成-湿氧氧化。
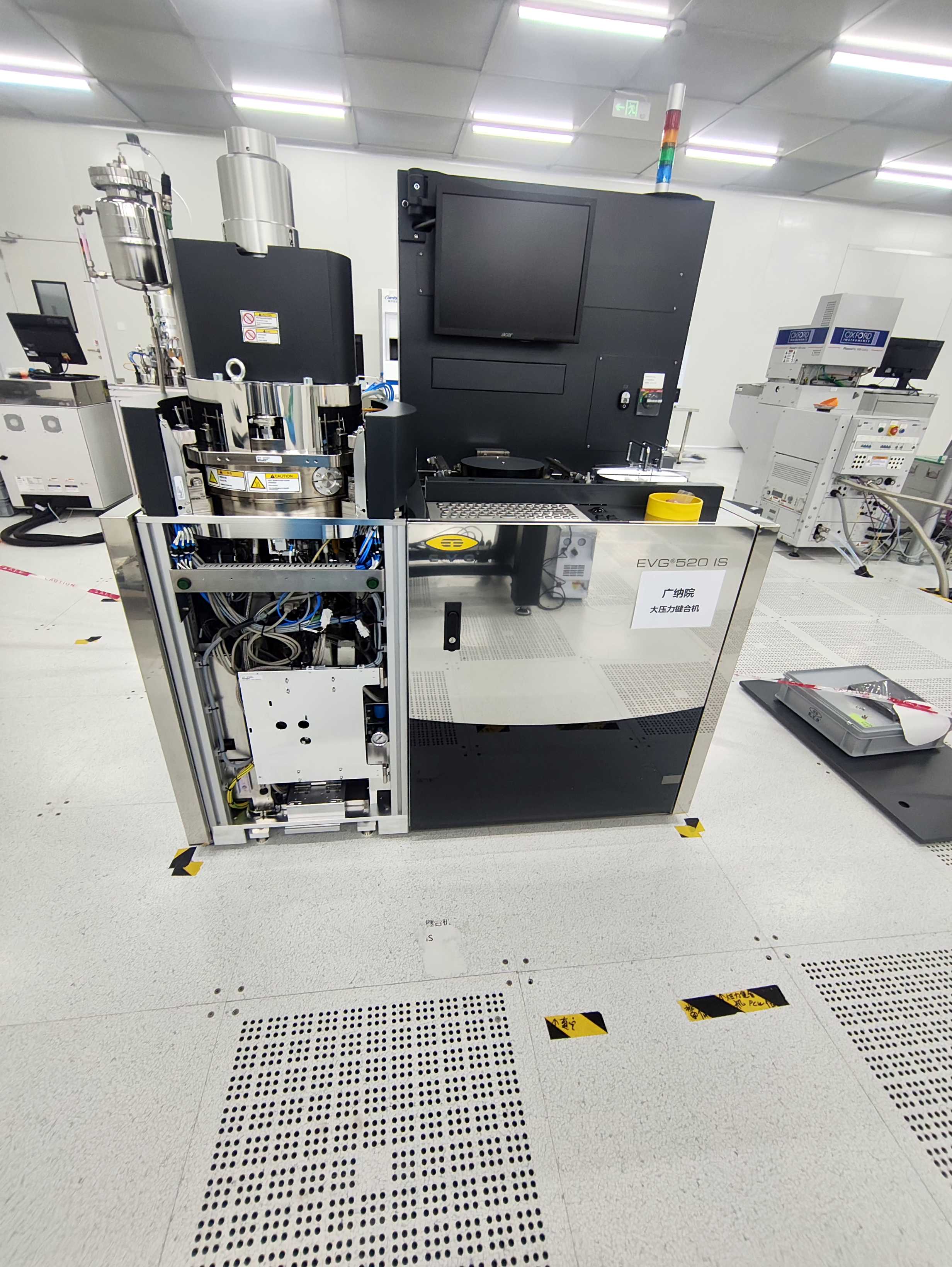
EVGroup EVG520IS
大压力键合机
6/8英寸兼容,最大压力大于50KN,最高温度500℃,支持氮气,精度±5μm;金属热压键合、金属共晶键合等功能。

EVGroup EVG510
键合机
4/6/8英寸兼容,最大压力可达3000mBar,最高电压可到-1500V,支持氮气,可以完成阳极键合,浆料键合。

昆山基侑 P300
备件清洗
用于部件清洗(如石英舟等)
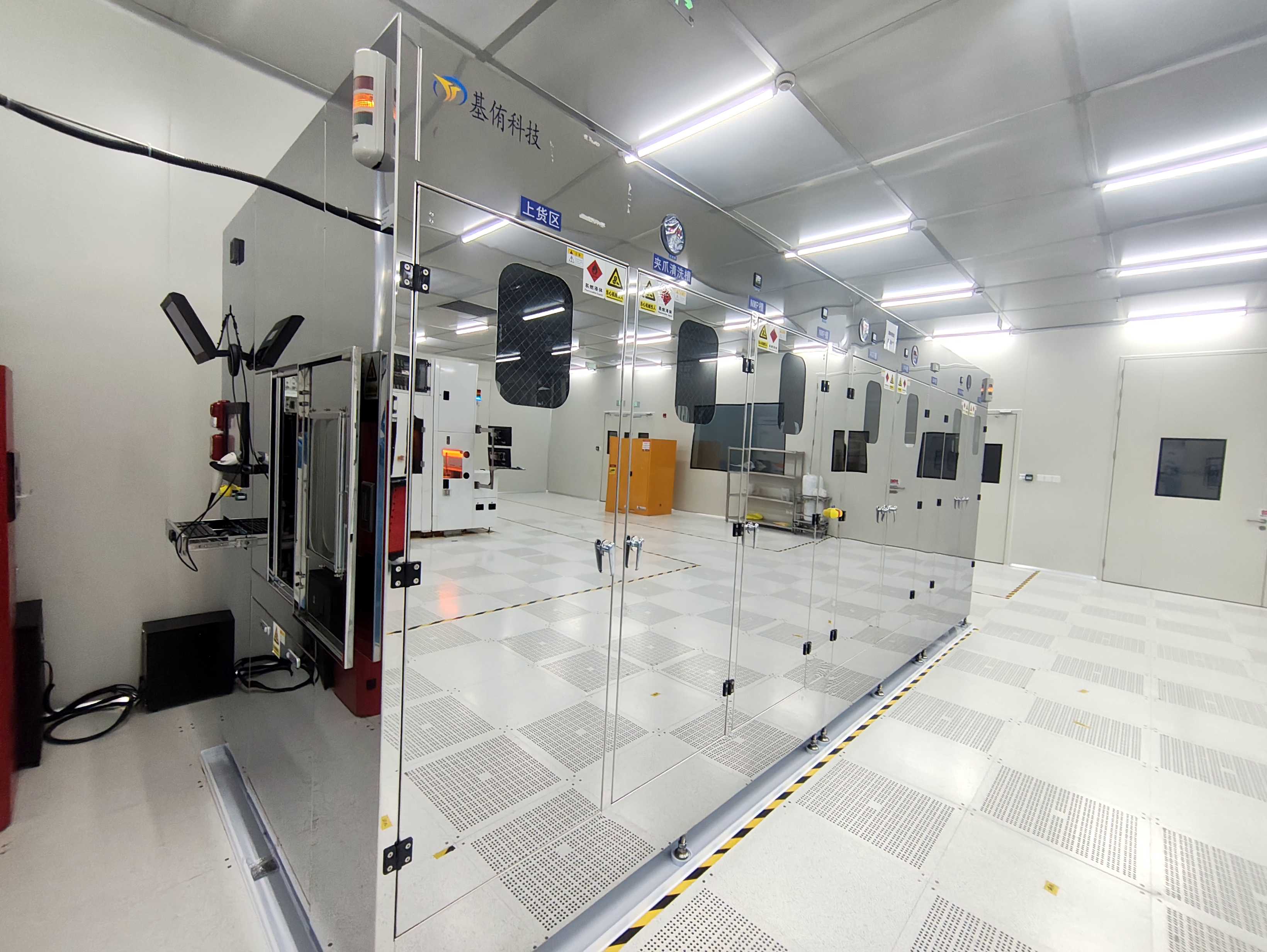
昆山基侑 W2200
无机清洗台
适用于6/8英寸;用于用于晶圆半导体工艺中工艺中无机药液清洗和湿法腐蚀工艺

昆山基侑 W5500
有机清洗台
适用于6/8英寸;主要用于晶圆半导体工艺中有机药液去光刻胶等有机物清洗

江苏矽智 CZ-P2000
电镀槽
适用于6/8英寸;用于晶圆MEMS芯片互连线路或者结构件厚金属(Cu Ni Au)沉积和硅通孔(TSV)金属填充制作。

Carl Zeiss AG Sigma300
SEM系统
电压15kV,工作距离4 mm,分辨率1nm,主要用于器件的表征与分析,高分辨显微成像,微区元素分析.

Carl Zeiss AG Crossbeam 550L
FIB系统
场发射,具备FIB功能,具备元素分析功能,放大倍数可达30万,样品台可旋转,主要用于8英寸以内晶圆进行截面切割观察,成分分析,晶圆缺陷检测分析等.
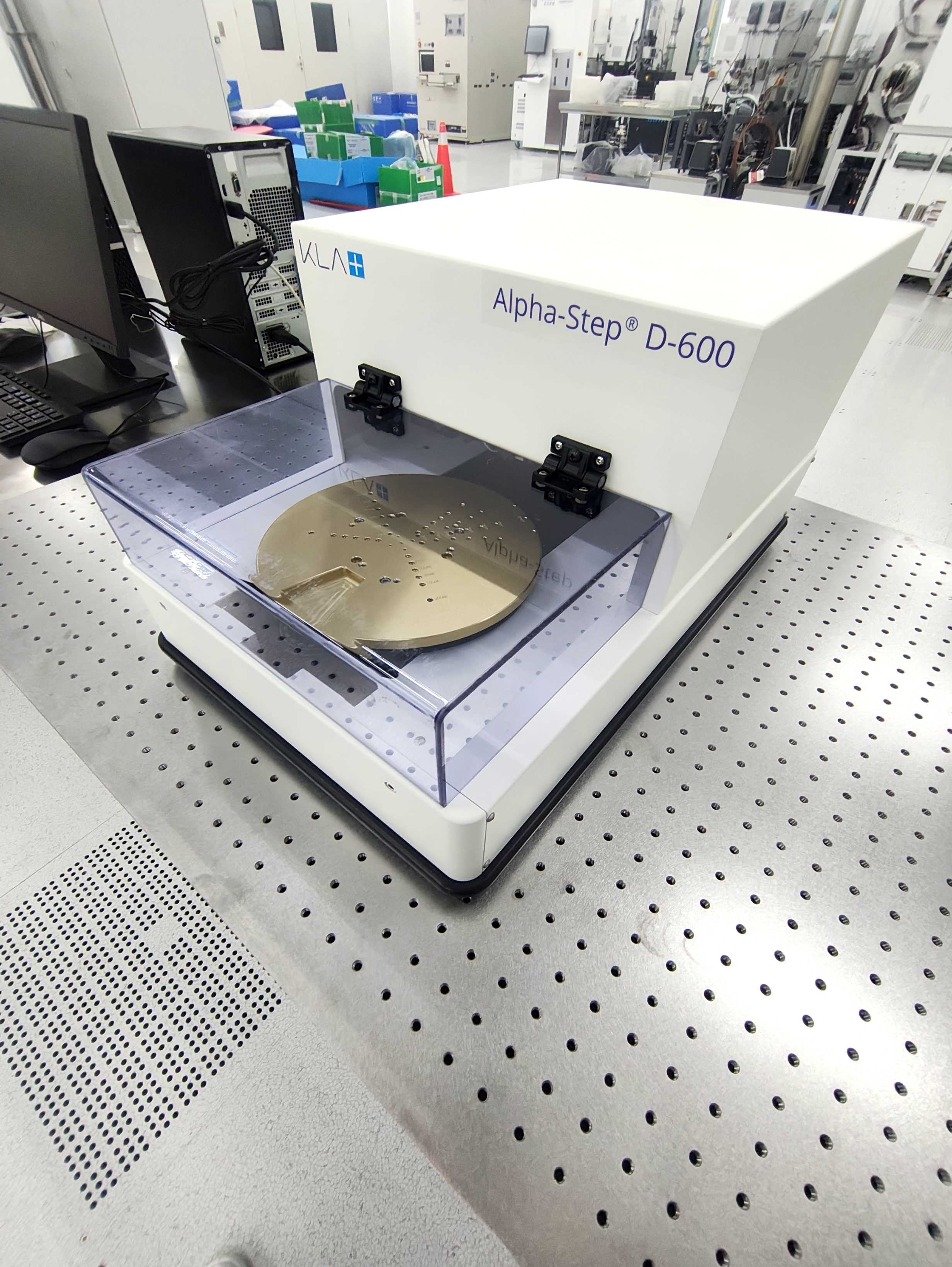
KLA Alpha-Step®D-600
台阶仪
适用4/6/8英寸;最大量测长度≥55mm,重复性 < 5 Å(台阶≤1μm)或< 0.1%(台阶>1μm)
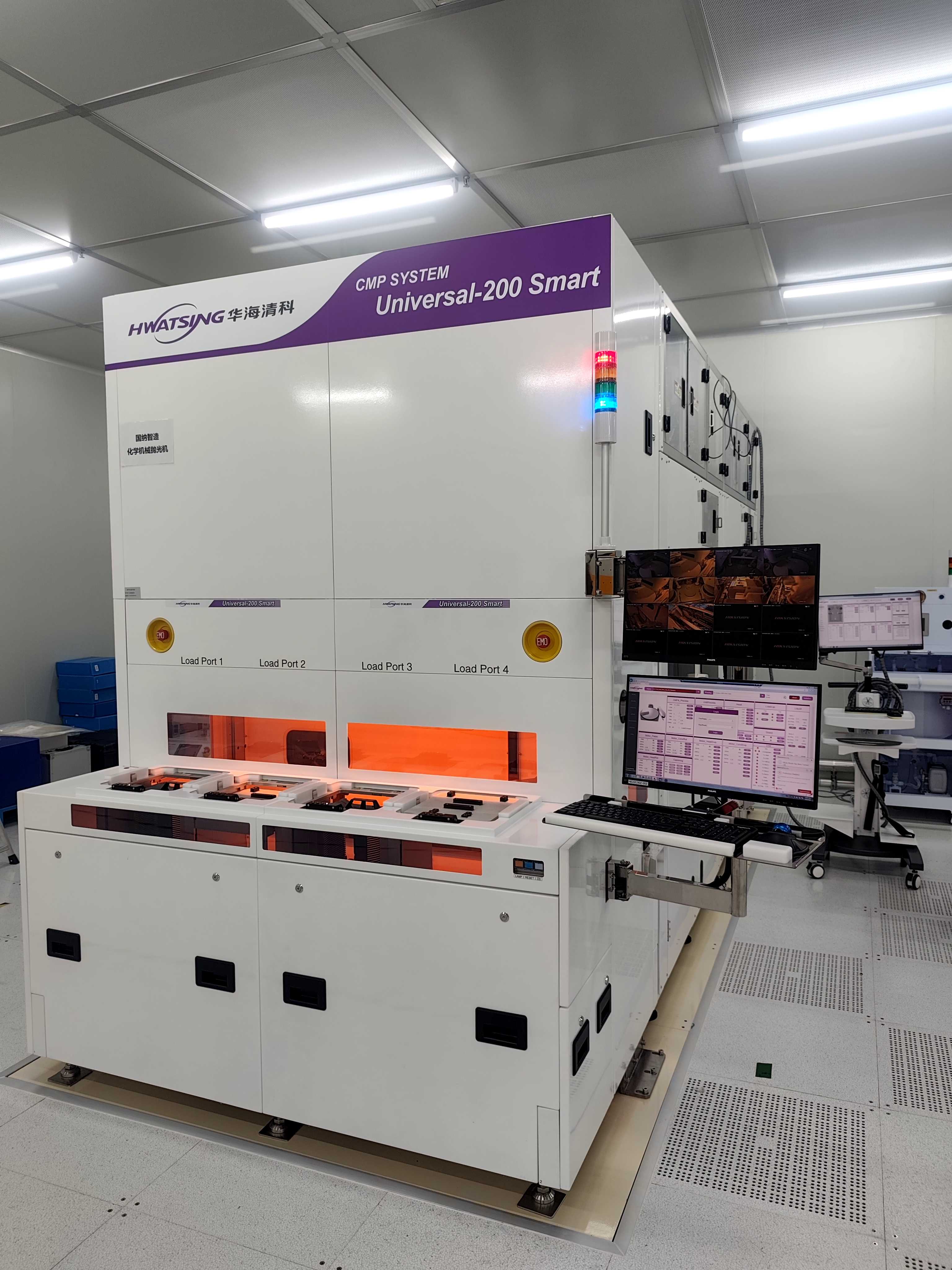
华海清科 Universal-200smart
化学机械抛光机
6/8英寸兼容,支持硅、氧化硅抛光,2-3个磨盘,粗糙度<0.5nm,dishing<30nm,干进干出

荷兰 Tempress Systems TS8603BM
低压化学气相沉积
适用于6/8英寸,最高温度800℃,支持50片以上晶圆,均匀性<5%,颗粒<30颗(>0.2μm),可生长Si3N4、LS-Si3N4、Poly Si、Doped Poly、TEOS SiO2和 BPSG等薄膜材料。

ULVAC CC-200Cz
原子层沉积
适用于6/8英寸,用于沉积氧化物薄膜材料,如 Al203、H02、Zr02 等薄膜材料和沉积氮化物薄膜材料,如 AIN,TiN,Pt等薄膜材料.

ULVAC Ei-7z
电感耦合等离子体化学气相沉积
4/6/8英寸兼容,氧化硅沉积,非晶硅沉积,具备应力调控系统,均匀性±5%, 圆形基片的薄膜沉积用于沉积介质膜(Si02、SiNx、非晶硅)。

ULVAC Esz-R
电子束蒸发
4/6/8英寸兼容,金属薄膜沉积,支持4个以上坩埚,均匀性±5%,本地真空优于5E-4Pa,可蒸发沉积 Al、Au、Ag、Cr、Cu、Mo、Ni、Pt、Sn、Ti等金属薄膜。

ULVAC CS-200z
多靶磁控溅射
4/6/8英寸兼容,支持3种以上靶位,支持直流、射频和脉冲溅射,均匀性±5%,可进行双靶共溅射,靶材可选用Al、Ag、Ti、Ni、Au等。
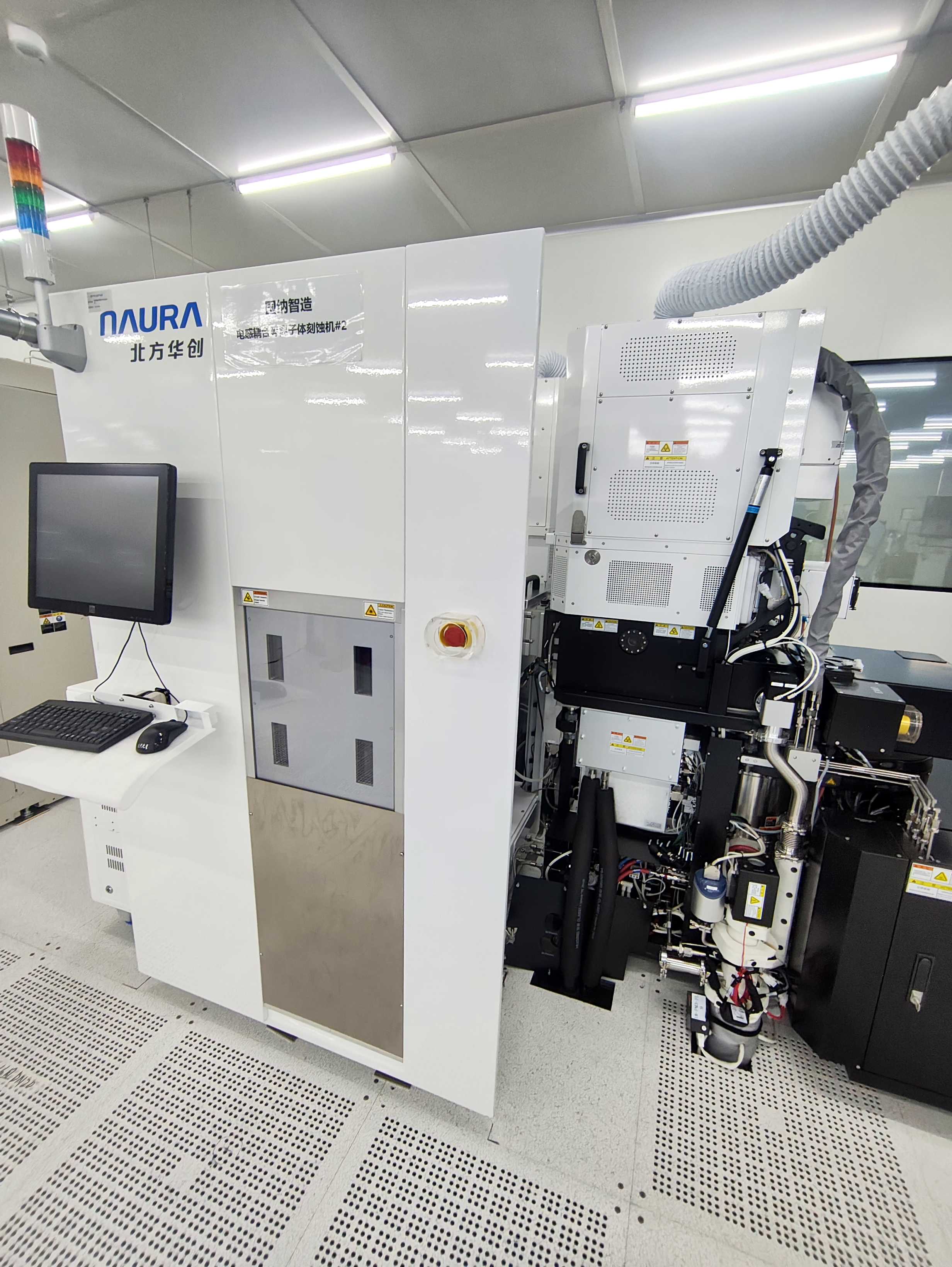
北方华创 HSE M200
电感耦合等离子体刻蚀机#2(硅材料刻蚀)
全自动,4/6/8英寸兼容,支持F基刻蚀气体,支持6路气体,RF300W,ICP1000W,均匀性±5%;高深宽比(大于50:1)刻蚀;Bosch工艺。
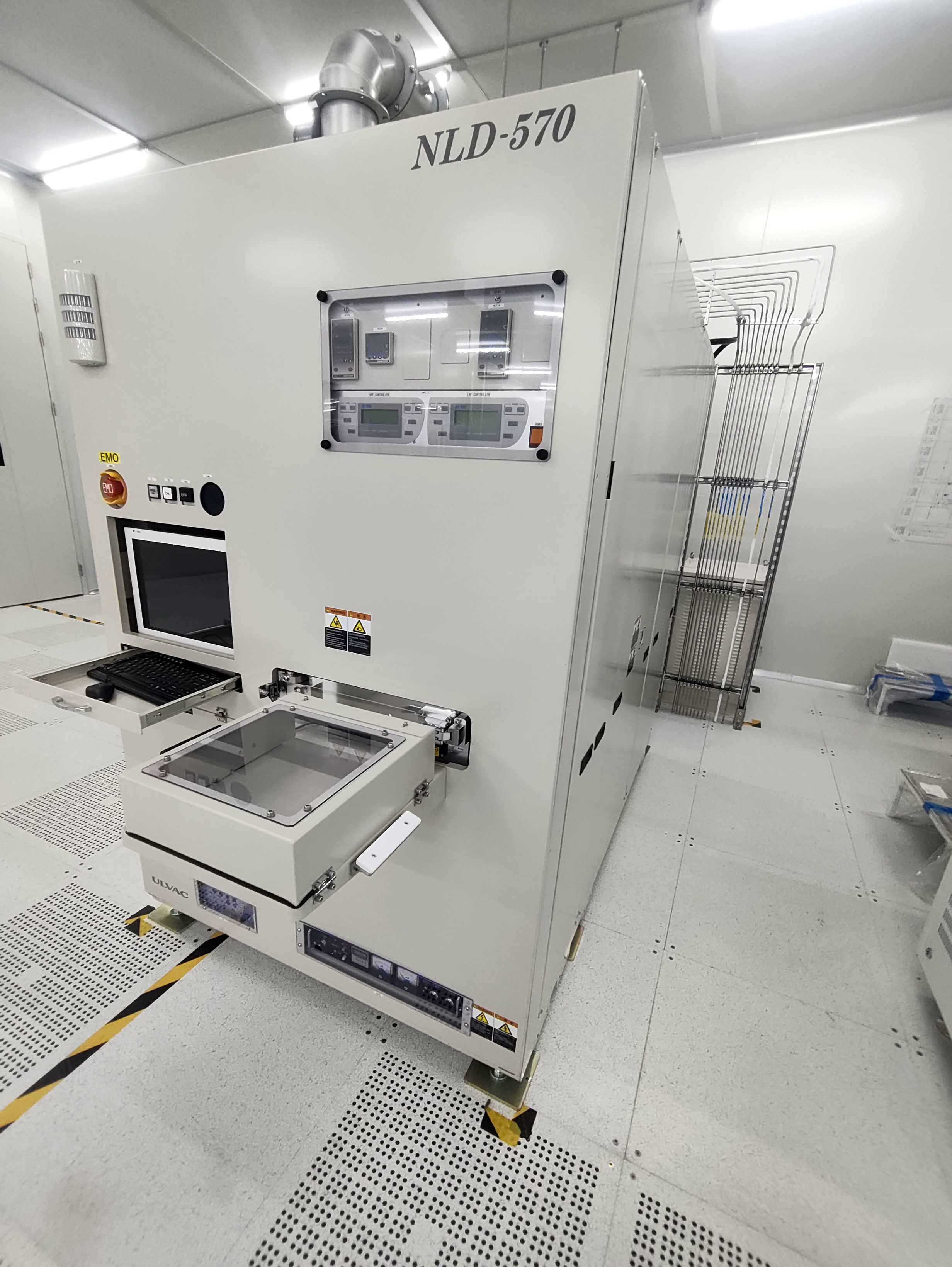
ULVAC NLD-570
电感耦合等离子体刻蚀机#1(介质膜刻蚀)
6/8英寸兼容,支持F基刻蚀气体,支持6路以上气体,均匀性±5%,硅材刻蚀。

江苏鲁汶 TerbankTM Lorem®A
刻蚀系统
6/8英寸兼容,载片台可以倾斜,晶圆可旋转,Au刻蚀速率>50nm/min,均匀性±3%含IBE、ICP、PECVD三个工艺模块。
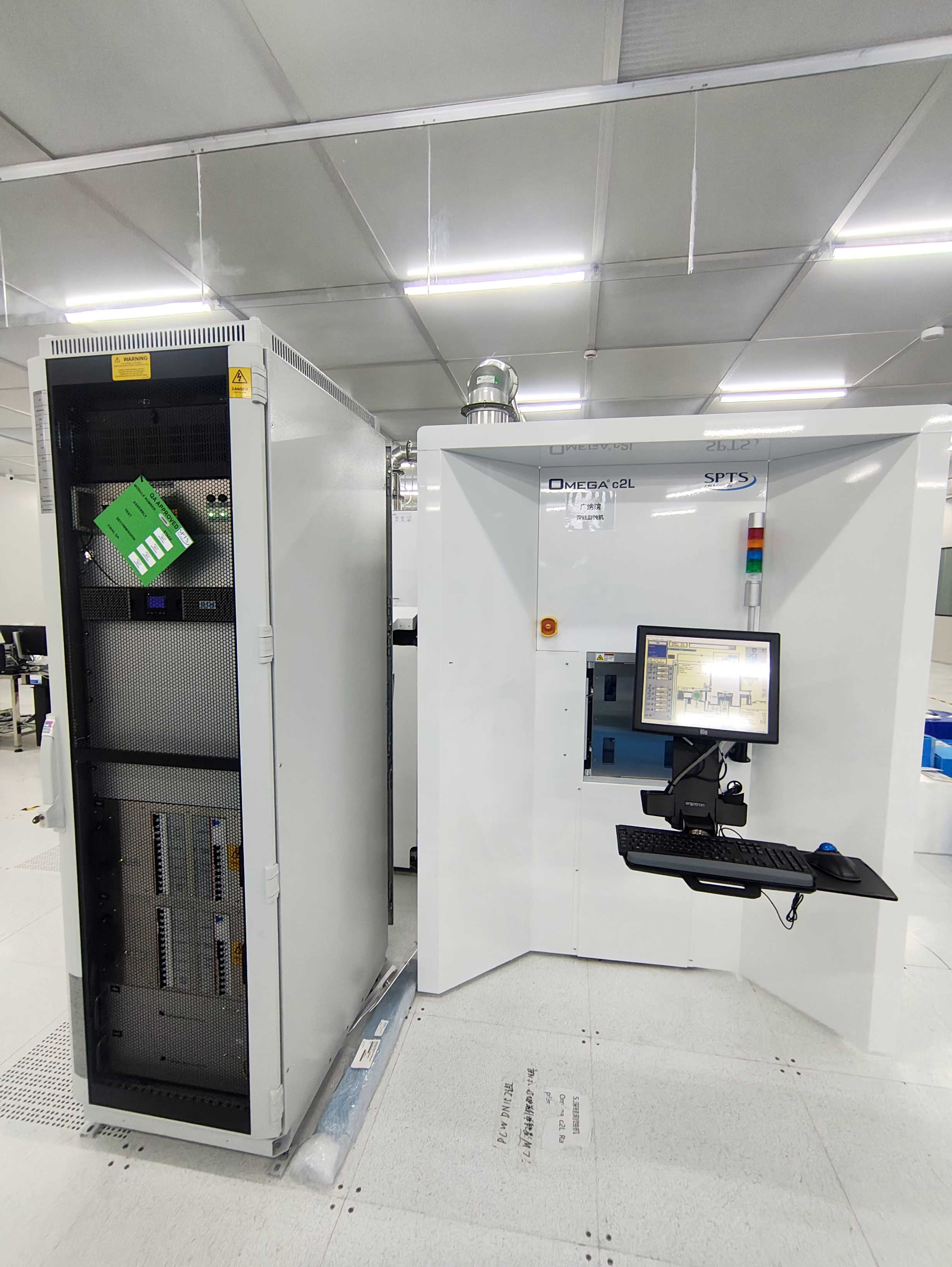
SPTS Omega c2L Rapier
深硅刻蚀机
6/8英寸兼容,刻蚀速率3μm/min,光刻胶选择比大于100:1,深宽比大于50:1,均匀性±5%;最小线宽≤500nm
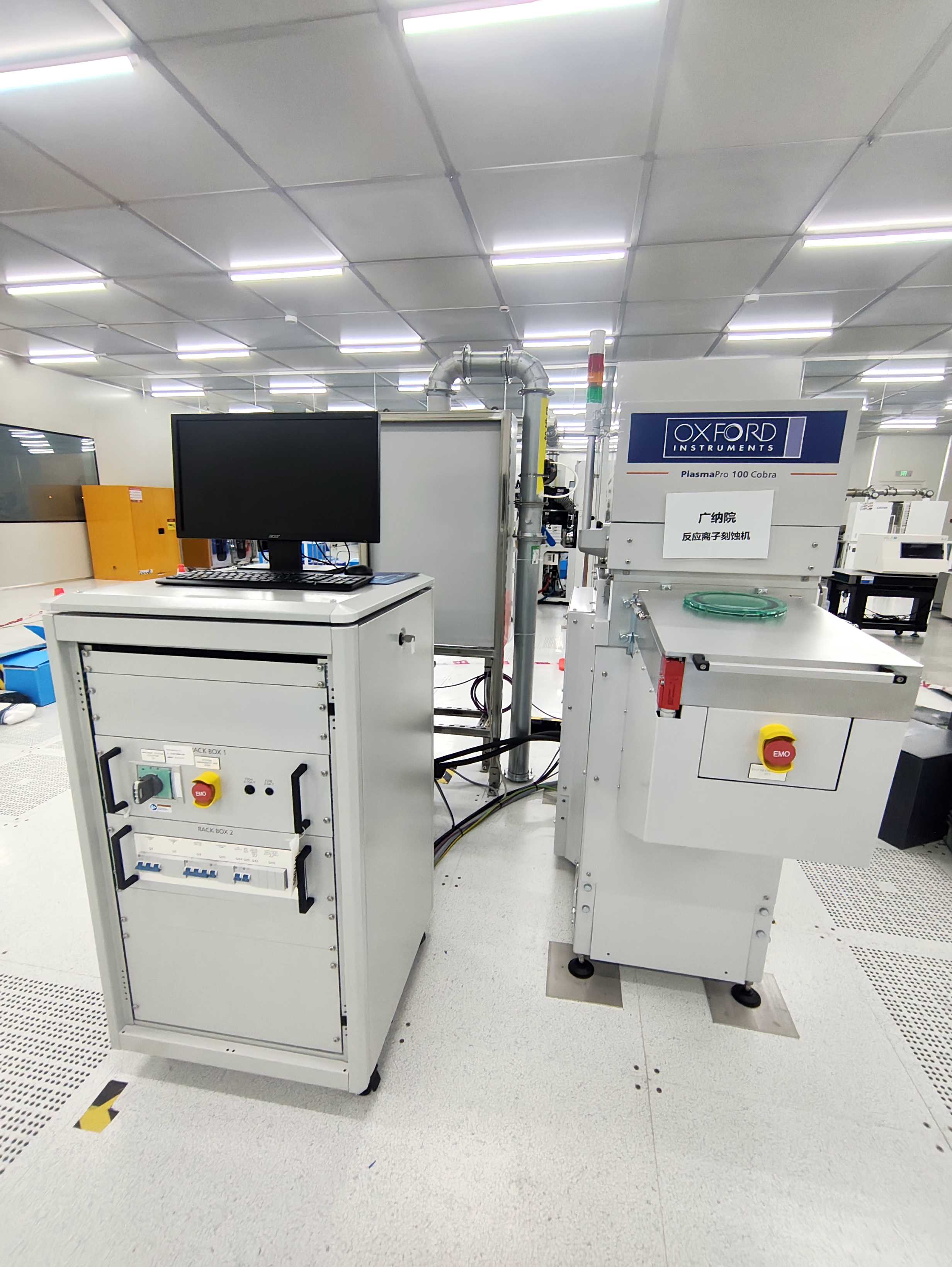
Oxford Instruments PlasmaPro 100 Cobra
反应离子刻蚀机
6/8英寸兼容,支持F基气体,同时支持4路气体,RF400W,均匀性±5%;SiO2、SiNx薄膜刻蚀;单片loadlock自动传送

PVA TePla IoN 40
等离子清洗
手动,适用6/8英寸和不规则片;配备射频电源不小于600W;WIW 10%、WTW 10%

SINO Plasma 100
干法去胶(自动)
光刻胶去胶速率>1000nm/min;光刻胶去胶均匀性:片内<25%,片间<15%;批间<15%,刻蚀后去胶缺陷数与当层光刻前缺陷对比增加量<20ea(粒径>0.2µm)

Alpha plasma Q 240
干法去胶(手动)
手动,适用6/8英寸和不规则片;光刻胶去胶速率>1000nm/min;光刻胶去胶均匀性:片内<25%,片间<15%;批间<15%,刻蚀后去胶缺陷数与当层光刻前缺陷对比增加量<20ea(粒径>0.2µm)